Study on Material Removal Rate in Lapping of SiC Single Crystal Wafer
-
摘要: 碳化硅(SiC)单晶片属于难加工材料,在使用之前必须要进行研磨与抛光。材料去除率(Material removal rate,MRR)是衡量SiC单晶片研磨与抛光效率的重要因素。针对传统研磨与抛光过程中考虑磨粒摩擦磨损时建立的材料去除率公式对材料去除的不足,考虑SiC单晶片研磨时磨粒挤压嵌入阶段的材料去除,建立了新型的材料去除率公式。根据SiC单晶片、磨粒与研磨盘之间的接触状态,推导出了包含嵌入阶段和摩擦磨损阶段材料去除的新型MRR数学模型;结合材料的物理特性(如硬度与弹性模量等),进行研磨实验。实验结果与模型预测结果表明,新型材料去除率公式的预测结果更接近实际情况。Abstract: Silicon carbide (SiC) single crystal wafer is difficult to be machined, which must be lapped and polished. The material removal rate (MRR) is an important factor in the lapping and polishing of SiC single crystal wafer, and which has great significance for SiC single crystal wafer processing. In traditional process of grinding and polishing, the deficiency of material removal rate (MRR) model is due to considering friction and wear of abrasive particles. Considered the material removal of the lapping particles in the extrusion stage, a new model for material removal rate of SiC single crystal wafer is established. According to the contact state between SiC single crystal wafer, particles and pad, a new model for MRR is established contain embedded phases and the friction and wear of the material removal rate. Combing the hardness and modulus of elasticity for grinding experiments, the experimental results are compared with the predicted. It is concluded that the predicted via the present MRR model is closer to the physical truth.
-
Key words:
- SiC single crystal wafer /
- lapping /
- abrasive /
- MRR
-
表 1 不同转速下的实验与预测MRR结果(压强为18.8 kPa)
研磨盘转速/(r·min-1) 10 20 30 40 50 60 实验值 MRR/(nm·min-1) 46.633 95.935 131.236 175.544 225.935 271.236 改进前[11] MRR/(nm·min-1) 40.250 81.783 110.513 145.838 185.773 220.119 相对误差/% 13.688 14.752 15.791 16.922 17.776 18.846 改进后 MRR/(nm·min-1) 43.856 89.923 121.910 161.867 206.945 246.645 相对误差/% 5.954 6.627 7.106 7.791 8.405 9.066 表 2 不同压强下的MRR实验与预测MRR结果(转速为40 r/min)
研磨压强/kPa 5 8 11 14 17 20 实验值 MRR/(nm·min-1) 43.353 73.113 104.412 133.448 167.584 197.204 改进前[11] MRR/(nm·min-1) 38.638 64.699 91.665 116.116 145.008 169.124 相对误差/% 10.876 11.509 12.209 12.988 13.472 14.239 改进后 MRR/(nm·min-1) 41.225 69.108 97.782 124.124 154.630 180.742 相对误差/% 4.908 5.478 6.349 6.987 7.730 8.348 -
[1] Deng H, Endo K, Yamamura K. Damage-free and atomically-flat finishing of single crystal SiC by combination of oxidation and soft abrasive polishing[J]. Procedia CIRP, 2014, 13:203-207 doi: 10.1016/j.procir.2014.04.035 [2] 张玉明, 汤晓燕, 张义门.SiC功率器件的研究和展望[J].电力电子技术, 2008, 42(12):60-62 doi: 10.3969/j.issn.1000-100X.2008.12.022Zhang Y M, Tang X Y, Zhang Y M. Study and perspective on SiC power devices[J]. Power Electronics, 2008, 42(12):60-62(in Chinese) doi: 10.3969/j.issn.1000-100X.2008.12.022 [3] 王军喜, 刘喆, 魏同波, 等.第3代半导体材料在光电器件方面的发展和应用[J].新材料产业, 2014, (3):18-20 doi: 10.3969/j.issn.1008-892X.2014.03.005Wang J X, Liu Z, Wei T B, et al. Development and application of third generation semiconductor materials in optoelectronic devices[J]. Advanced Materials Industry, 2014, (3):18-20(in Chinese) doi: 10.3969/j.issn.1008-892X.2014.03.005 [4] 叶恒宇, 覃寿同, 王栋, 等.磁力研磨调质45钢的工艺参数和表面形貌研究[J].机械科学与技术, 2017, 36(8):1292-1297 http://journals.nwpu.edu.cn/jxkxyjs/CN/abstract/abstract6773.shtmlYe H Y, Qin S T, Wang D, et al. Study on processing parameters and surface morphology of quenched and tempered 45 steel in magnetic abrasive finishing[J]. Mechanical Science and Technology for Aerospace Engineering, 2017, 36(8):1292-1297(in Chinese) http://journals.nwpu.edu.cn/jxkxyjs/CN/abstract/abstract6773.shtml [5] Zhou L B, Shimizu J, Shinohara K, et al. Three-dimensional kinematical analyses for surface grinding of large scale substrate[J]. Precision Engineering, 2003, 27(2):175-184 doi: 10.1016/S0141-6359(02)00225-8 [6] Jin X L, Zhang L C. A statistical model for material removal prediction in polishing[J]. Wear, 2012, 274-275:203-211 doi: 10.1016/j.wear.2011.08.028 [7] Li P Y, Wang Z J, Li X Y, et al. Elasto-plastic indentation of a half-space by a rigid sphere under normal and torque loading[J]. Tribology International, 2013, 62:141-148 doi: 10.1016/j.triboint.2013.02.015 [8] Xu W H, Lu X C, Pan G S, et al. Effects of the ultrasonic flexural vibration on the interaction between the abrasive particles; pad and sapphire substrate during chemical mechanical polishing (CMP)[J]. Applied Surface Science, 2011, 257(7):2905-2911 doi: 10.1016/j.apsusc.2010.10.088 [9] 刘折, 赵波, 郑友益, 等.超声ELID复合磨削陶瓷材料高效去除机理的仿真研究[J].兵器材料科学与工程, 2014, 37(5):27-31 doi: 10.3969/j.issn.1004-244X.2014.05.007Liu Z, Zhao B, Zheng Y Y, et al. Simulation on mechanism of ceramic removal by ultrasonic ELID composite grinding[J]. Ordnance Material Science and Engineering, 2014, 37(5):27-31(in Chinese) doi: 10.3969/j.issn.1004-244X.2014.05.007 [10] 胡海明, 李淑娟, 高晓春, 等.SiC单晶片研磨过程材料去除率仿真与试验研究[J].兵工学报, 2013, 34(9):1125-1131 http://d.old.wanfangdata.com.cn/Periodical/bgxb201309011Hu H M, Li S J, Gao X C, et al. Simulation and experiment of MRR in lapping process of SiC monocrystal wafers[J]. Acta Armamentarii, 2013, 34(9):1125-1131(in Chinese) http://d.old.wanfangdata.com.cn/Periodical/bgxb201309011 [11] Pohl M C, Griffiths D A. The importance of particle size to the performance of abrasive particles in the CMP process[J]. Journal of Electronic Materials, 1996, 25(10):1612-1616 doi: 10.1007/BF02655584 [12] Kumar A, Mahapatra M M, Jha P K. Modeling the abrasive wear characteristics of in-situ synthesized Al-4.5%Cu/TiC composites[J]. Wear, 2013, 306(1-2):170-178 doi: 10.1016/j.wear.2013.08.013 [13] Uhlmann E, Doits M, Schmiedel C. Development of a material model for visco-elastic abrasive medium in Abrasive Flow Machining[J]. Procedia CIRP, 2013, 8:351-356 doi: 10.1016/j.procir.2013.06.115 [14] Bielmann M, Mahajan U, Singh R K. Effect of particle size during tungsten chemical mechanical polishing[J]. Electrochemical and Solid-State Letters, 1999, 2(8):401-403 doi: 10.1149/1.1390851 [15] 许迪初, 汪久根.粗糙表面的弹塑性接触研究[J].摩擦学学报, 2016, 36(3):371-379 http://d.old.wanfangdata.com.cn/Periodical/zgjxgc200722024Xu D C, Wang J G. On deterministic elastoplastic contact for rough surfaces[J]. Tribology, 2016, 36(3):371-379(in Chinese) http://d.old.wanfangdata.com.cn/Periodical/zgjxgc200722024 [16] Zhao Y W, Chang L. A micro-contact and wear model for chemical-mechanical polishing of silicon wafers[J]. Wear, 2002, 252(3-4):220-226 doi: 10.1016/S0043-1648(01)00871-7 [17] Luo J F, Dornfeld D A. Material removal mechanism in chemical mechanical polishing:theory and modeling[J]. IEEE Transactions on Semiconductor Manufacturing, 2001, 14(2):112-133 doi: 10.1109/66.920723 -







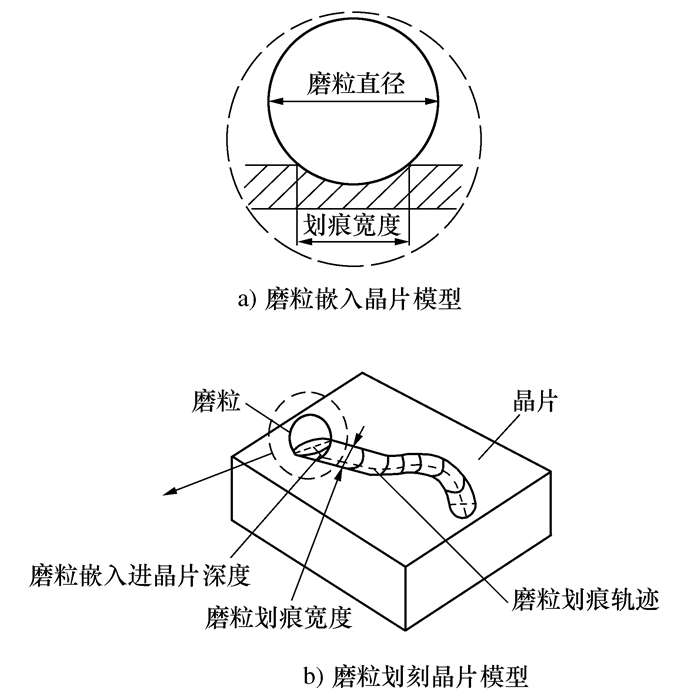
 下载:
下载: